Si les conférences telles l’Intel Foundry Direct Connect sont l’occasion de bons gros points techniques sur l’avancée de technologies de gravure de la firme et de grands coups de marketing quant aux changements de direction stratégique de cette dernière, ces événements ne sont — heureusement — pas constitués que de défilement de diapositives et de poudre aux yeux. En effet, nous avons pu poser nos yeux sur de très jolis wafers, mais également des prototypes forts intéressants d’intégration de systèmes de refroidissement liquide directement au niveau du package.


Dans l’idée, le principe est simple : au lieu de passer par un waterblock posé sur le processeur, comme c’est le cas des AiO grand public (mais également de certains systèmes à destination des data center), pourquoi ne pas directement intégrer la chose au CPU, et gagner ainsi toujours plus en efficacité ? Attention, il n’est pas question ici de projeter de l’eau sur le die nu (cette méthode, nommée Direct Die Cooling, impose des contraintes plus fortes encore sur l’étanchéité des composants montés en surface), mais de fusionner le maze (structures fines en ailettes maximisant la surface d’échange entre l’eau et le composant à refroidir) et l’IHS (Integrated Heatspreader, la partie métallique scellant la puce). Le résultat est une puce plus épaisse et munie de deux trous dans lesquels les connecteurs prennent place (pas de G 1/4 ici cependant, mais un tuyal bien plus fin).
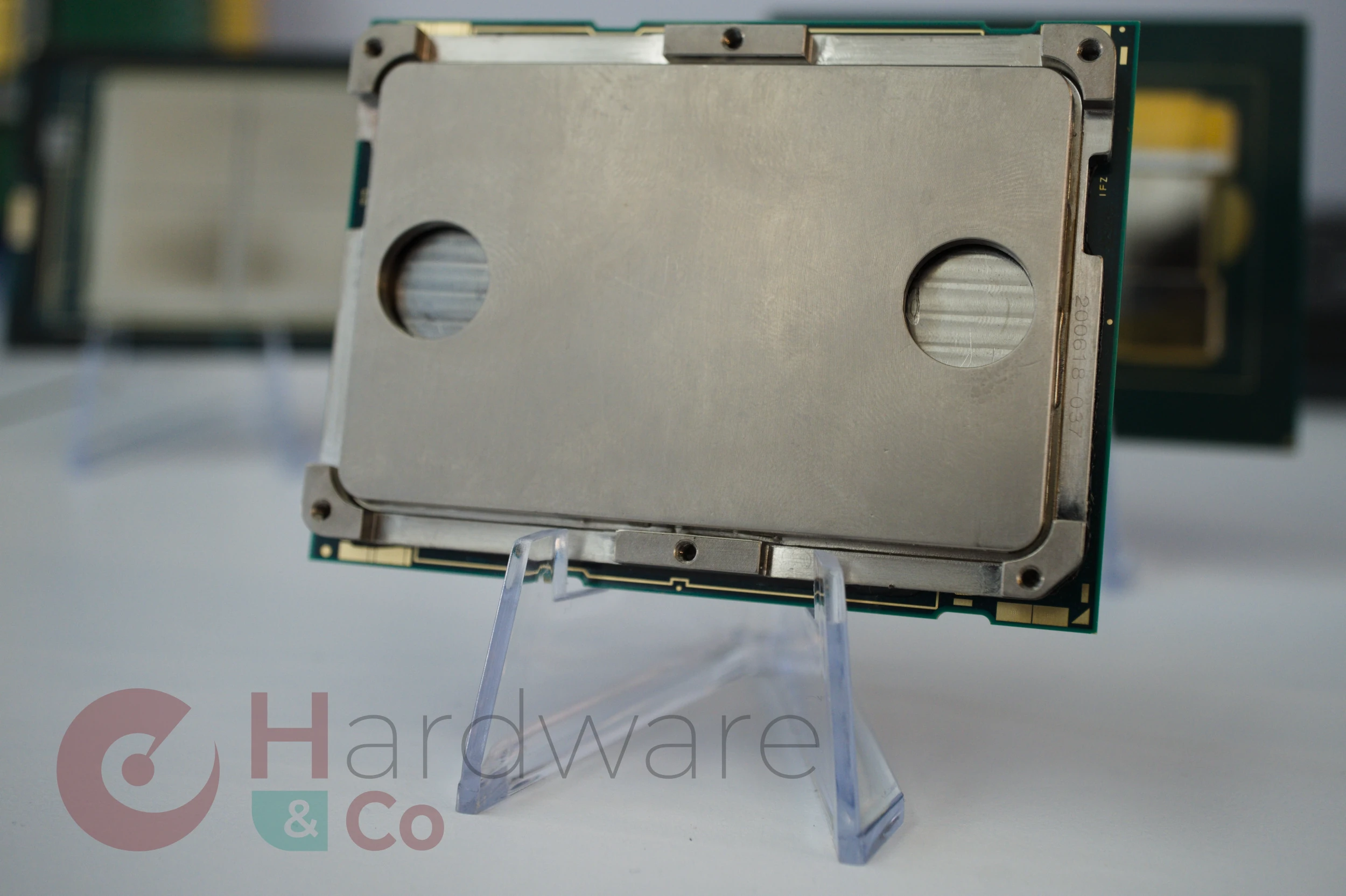
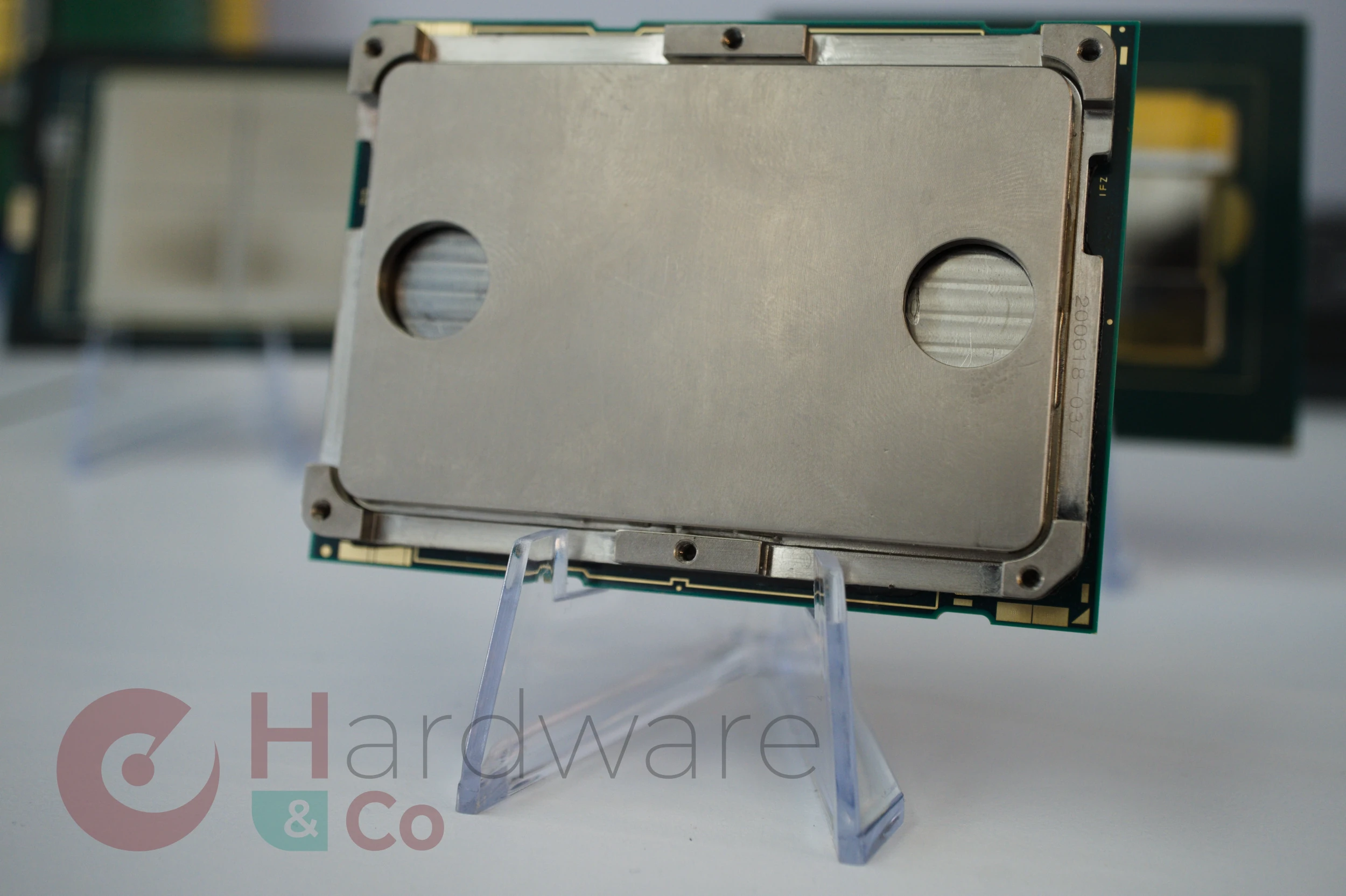
Du côté technique, Intel est resté très évasif à propos de son maze, qui était bien à disposition, mais sans pour autant pouvoir le photographier. Qu’à cela ne tienne, le modèle présenté proposait un espacement classique de 200 µm entre lamelles, rien de bien révolutionnaire dans le domaine. En revanche, la question de la pâte thermique utilisée sous la capsule était abondamment abordée : si Intel offre classiquement un composé polymère pour l’entrée de gamme, la soudure demeure la solution la plus performante, au détriment du coût. Et, dans les méthodes moins classiques, le géant bleu s’aventure à souder les processeurs BGA (Ball Grid Array, c’est-à-dire ceux de laptop ne faisant pas usage de socket), ou — plus exotique encore — avoir recours au métal liquide ! Cette dernière solution, encore en cours de mise au point, représenterait une offre médiane au niveau du coût et des performances entre le joint et le Nutella.
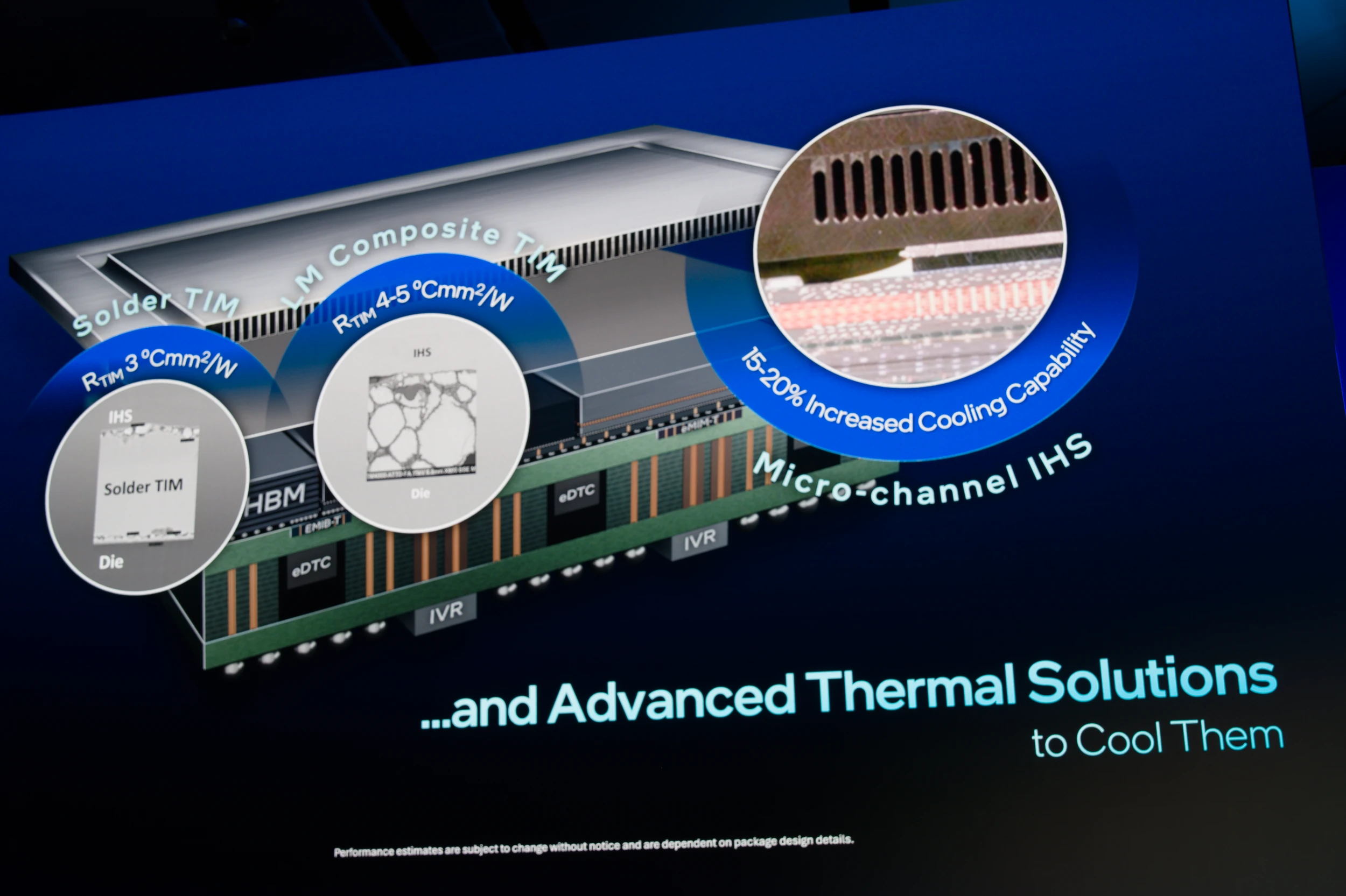
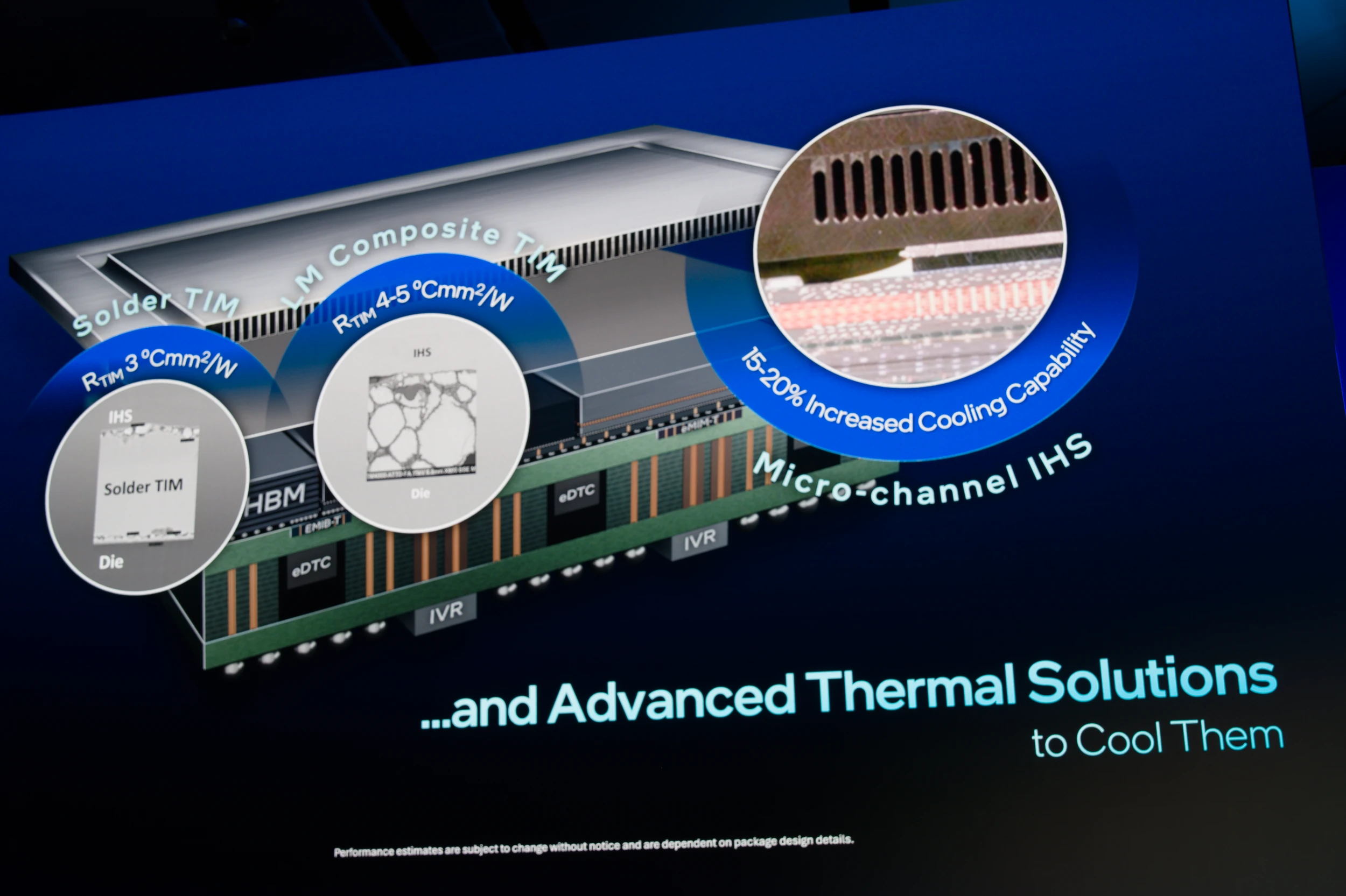
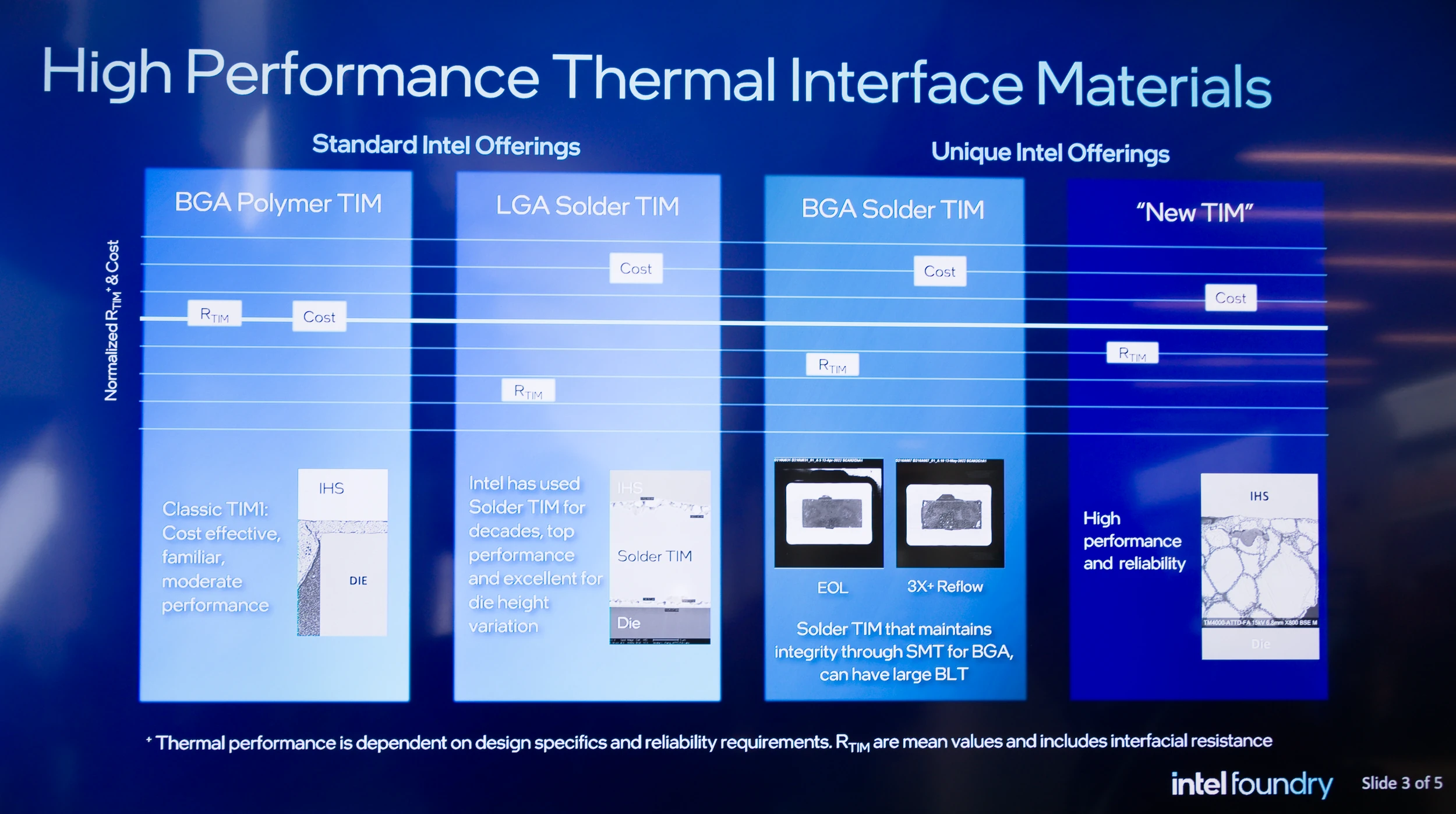
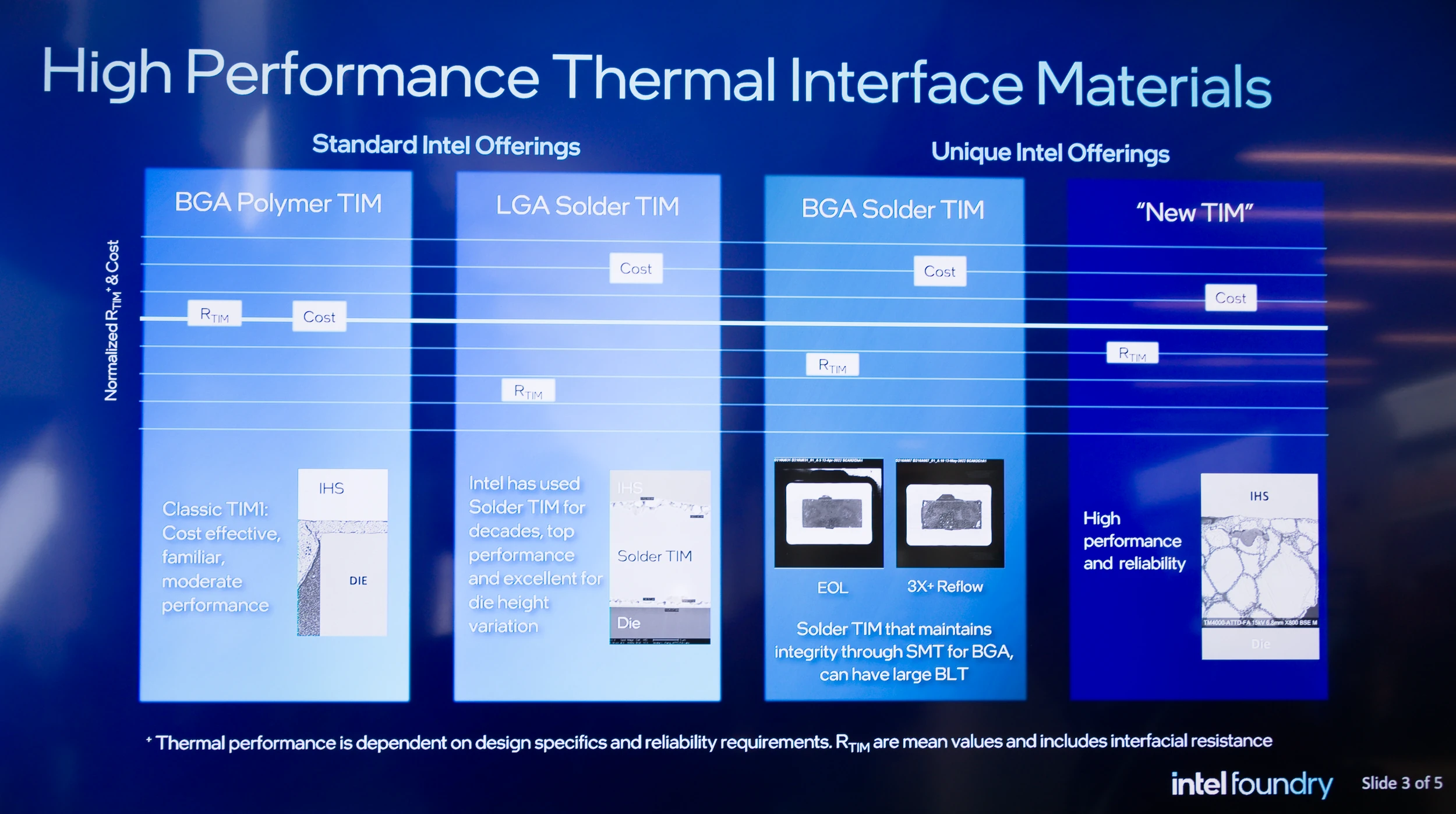
Reste une question de taille : où en est la mise au point ? Selon Intel, la technologie est fiabilisée et prête à être vendue à qui souhaite l’intégrer. Autant dire que les premiers modèles ne devraient pas tarder. Quant à savoir si un intégrateur sera suffisamment fou pour proposer cela au grand public, mystère et boule de gomme ! En tout cas, un modèle socketé type grand public était en exposition, laissant la porte ouverte à toutes les spéculations possibles : pourquoi pas une série de PC pour overclockeurs extrêmes chez un OEM ? Voilà qui fait rêver !
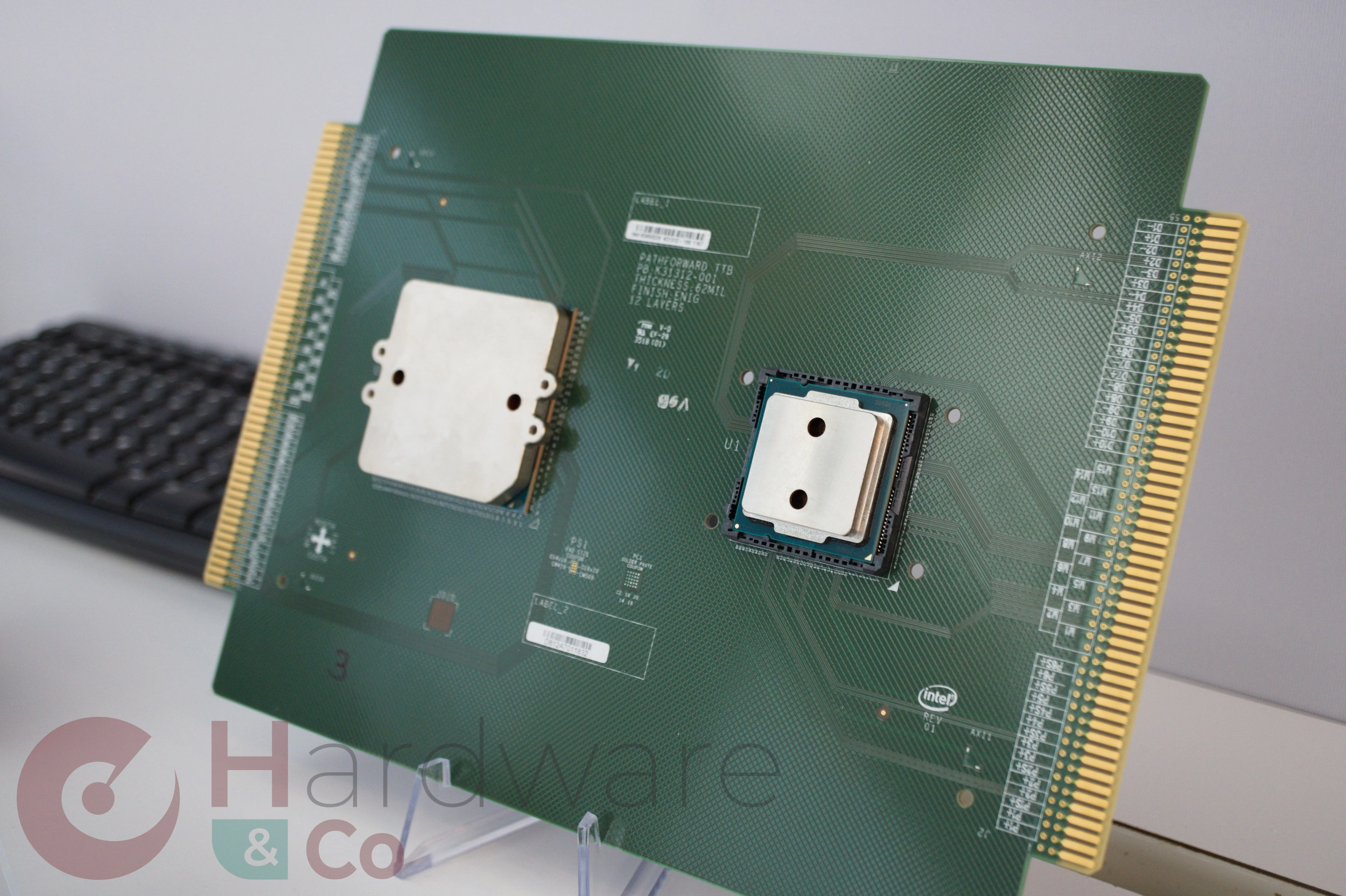
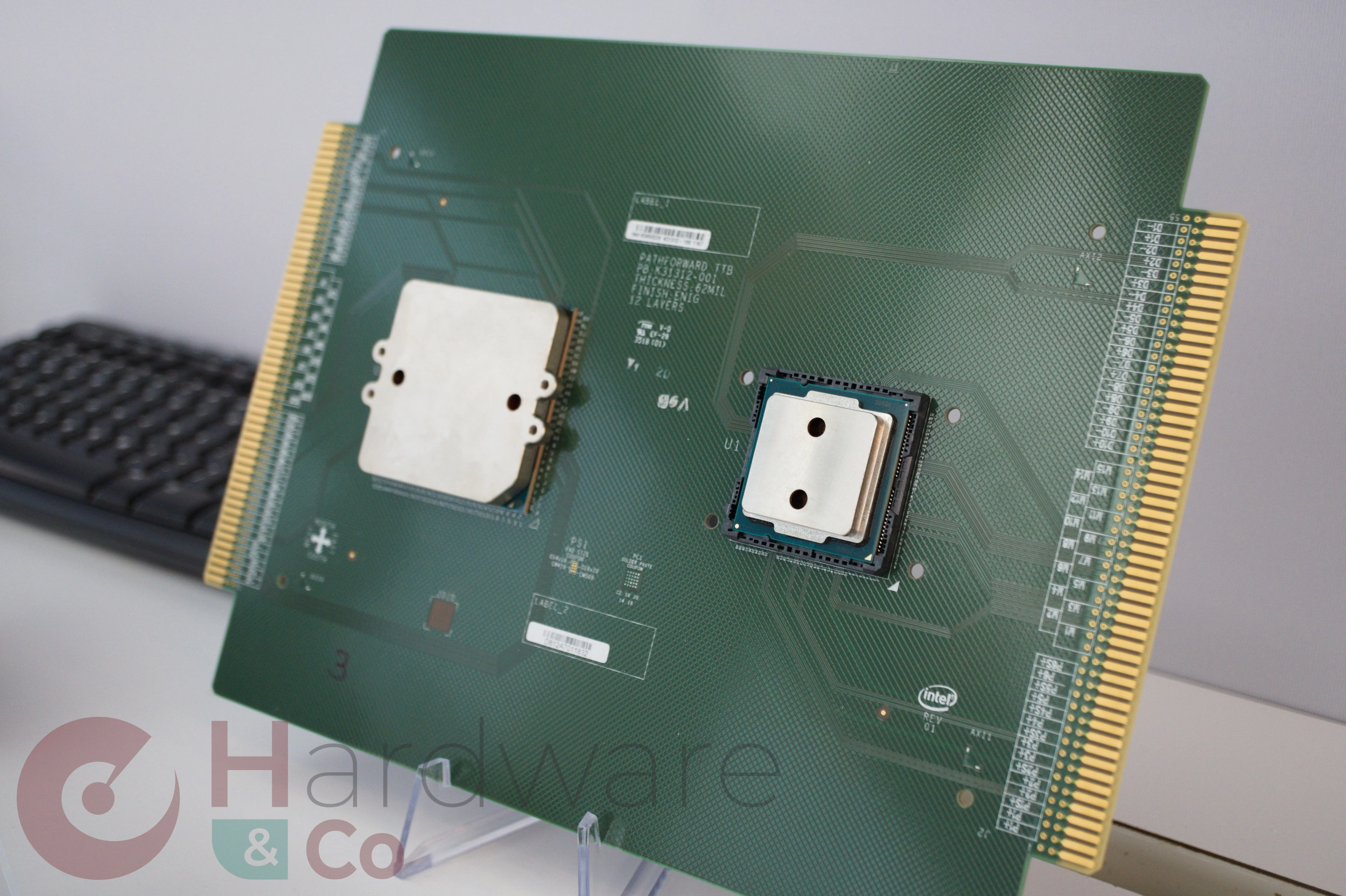






Pas mal considérant les solutions existantes en HPC, reste a voir si ça va faire baisser le cout comparativement a ce qui est déjà disponible vu que ça sera probablement la seule chose que les décideurs regarderont.
Pour les particuliers ça n'aura aucun intérêt,mais si un oem veut sortir un produit sans intérêt... (on me souffle que DELL via leur branche Alienware sont des spécialistes de ce genre de connerie 😅)
J'ai demandé texto "si une boite comme ASUS voulait s'équiper pour une série spéciale haute-performance, vous êtes ouverts à la vente ?" et on m'a répondu oui franc et fort. Tout sera après une question de coût par rapport au marché potentiel, et là, nous n'avons aucune information !
Intéressant, à voir dans la pratique l'installation, le tarif, date de sortie. J'espère une version adaptée aux embouts G 1/4.
Intéressant a suivre
avec de l'azote si possible ? 😄