Doucement, mais surement, chaque acteur de l'industrie du semiconducteur se prépare, à son rythme, à l'adoption des EUV High-NA (High Numerical Aperture Extreme Ultraviolet Lithography). Ayant misé beaucoup sur cette évolution technologique, notamment pour son futur procédé 14A, Intel avait été, en 2024, le premier fondeur à installer un scanner lithographique EUV High-NA TwinScan EXE:5000 de chez ASML dans son usine D1X. Il s'agissait alors plutôt d'un système prototype de préproduction, pouvant néanmoins être mis à niveau pour être adapté à la fabrication en volume de wafers.
Le mois dernier, ASML avait ensuite annoncé avoir expédié le premier système TwinScan EXE:5200B. Une évolution et amélioration du système précédent, cette fois-ci conçu d'origine pour produire en volume. Compte tenu des actualités précédentes, la spéculation de vigueur était que la machine partait en direction des USA, vers chez Intel, jusqu'à présent le fondeur le plus en vue dans le domaine des ultraviolets extrêmes High-NA, pour faire avancer le travail avec le 14A.

En fin de compte, c'est la surprise ! Car ce n'est pas aux USA, mais en Corée du Sud que le premier modèle TwinScan EXE:5200B a été monté par ASML ! Plus spécifiquement, chez SK hynix, dans son fab M16 à Icheon. Celui-ci est une usine ni de R&D ni de préproduction, mais bien un site de fabrication en volume pour le marché mondial, ce qui en dit long sur les ambitions de SK hynix.
Nous espérons que l'ajout de cette infrastructure critique permettra de concrétiser la vision technologique que nous poursuivons. Nous souhaitons renforcer notre position de leader dans le domaine des mémoires pour l'IA grâce à la technologie de pointe requise par les marchés en pleine croissance de l'IA et de l'informatique de nouvelle génération.
Déclaration de SK hynix.
La technologie EUV à haute NA est une technologie essentielle qui ouvre un nouveau chapitre dans l'industrie des semi-conducteurs . ASML collaborera étroitement avec SK hynix afin de faire progresser l'innovation dans le domaine des mémoires de nouvelle génération.
Déclaration d'ASML.
Initialement, le géant coréen va s'en servir pour accélérer le développement de ses prochaines générations de technologies autour de la DRAM, ce qui implique de nombreux types de travaux et d'expérimentations. La nouvelle machine va notamment permettre la réalisation de prototypes détaillés de DRAM bien plus rapidement qu'avec les systèmes EUV Low-NA et DUV. Dans un premier temps, il s'agira toutefois de se faire la main avec les technologies de processus reposant sur les outils de productions actuels. L'élaboration de procédés nécessitant absolument un équipement EUV High-NA ne se fera que dans un second temps. Selon ASML, cette étape ne sera réellement franchie par les producteurs de DRAM qu'au cours de la prochaine décennie. Il y a donc encore le temps de voir venir, mais pour les fondeurs, cet avenir commence à se préparer maintenant. Dans ce contexte, SK hynix a désormais pris une longueur d'avance dans cette course face aux autres gros producteurs de DRAM, Micron et Samsung. Après tout, SK hynix a un nouveau statut à cimenter et un leadership en matière d'EUV à faire perdurer ! Rappelons que le coréen avait sauté sur la technologie dès 2021, alors que Micron a à peine commencé à s'en servir.
En matière d'EUV High-NA, Intel était jusqu'à présent seul à s'être lourdement investi, tandis que Samsung et TSMC se sont montrés bien plus prudents. Il faut dire que c'est une entreprise onéreuse. Un système EUV High-NA coute environ deux fois plus cher qu'un scanner EUV Low-NA, soit aux alentours des 400 millions d'euros. Certes, ce type de système de production est utilisable pendant des années et peut être mis à niveau. En théorie, une adoption précoce pourrait finir par se traduire par un avantage sur les concurrents.
Un TwinScan EXE:5200B est équipé d'une lentille à ouverture numérique (NA, Numerical Aperture) de 0,55 et atteint une définition de 8 nm, contre 13 nm pour un scanner EUV Low-NA. Ceci permet d'obtenir des transistors 1,7 fois plus petits et une densité 2,9 fois plus élevée en une seule exposition. En principe, ce type de résultat peut également être obtenu avec l'outillage actuel, mais au prix d'un "multi-patternage" couteux. L'EUV High-NA simplifie certaines opérations, mais introduit son lot de nouveaux défis techniques. (Source : SK hynix, Tom's)

Un TwinScan EXE:5200, habillé.





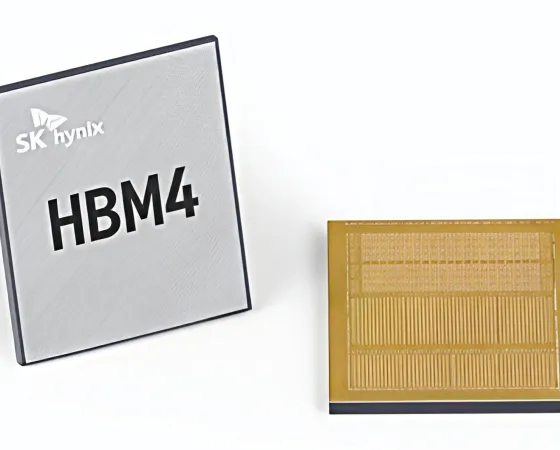

attention euv na réduit la taille maximal d'un die a 429 mm²